BGA
En Ball Grid Array (BGA) är en typ av ytmonterad förpackning som används för integrerade kretsar (ICs) och andra halvledarenheter. I ett BGA-paket görs anslutningarna mellan den integrerade kretsen och kretskortet (PCB) genom en uppsättning lödkulor placerade på undersidan av förpackningen. Dessa lödkulor fungerar som anslutningspunkter och är ordnade i ett rutmönster, därav namnet ”Ball Grid Array.”

Typer av BGA
- Keramisk BGA (CBGA):
- Använder ett keramiskt substrat för utmärkta termiska och mekaniska egenskaper.
- Idealisk för högpresterande applikationer inom flyg-, militär- och telekommunikationssystem.
- Plast BGA (PBGA):
- Använder ett plastsubstrat som erbjuder kostnadseffektivitet.
- Lämplig för hemelektronik med olika storlekar och konfigurationer.
- Flip-chip BGA (FCBGA):
- Använder en flip-chip-bindningsteknik för förbättrad elektrisk prestanda.
- Används vanligtvis i höghastighetsapplikationer som mikroprocessorer och grafikprocessorer.
- Tape Ball Grid Array (TBGA):
- Använder tejp för tillfällig placering av lödkulor under montering.
- Förbättrar hantering och placeringseffektivitet, vilket minskar risken för skador på lödkulan.
- Tapp BGA (SBGA):
- Har metallpinnar eller stolpar för elektriska anslutningar.
- Ger förbättrad mekanisk stabilitet, perfekt för fordonselektronik och robusta enheter.
-
- Mikro BGA (µBGA):
- Har mindre bollplaner för högre I/O-densitet och enhetsminiatyrisering.
- Används vanligtvis i mobila enheter och bärbar elektronik där utrymmet är begränsat.
BGA-komponenter kräver en specialiserad lödprocess, och våra återflödeslödningstekniker är skräddarsydda för att möta de unika utmaningarna med BGA-montering. Denna metod säkerställer tillförlitliga lödfogar för ökad hållbarhet och prestanda.
Röntgeninspektion för BGA-kvalitet: För att säkerställa integriteten hos BGA-enheter använder vi röntgeninspektionsteknik. Detta möjliggör icke-förstörande provning av lödfogarna under BGA-komponenterna, eventuella defekter eller avvikelser.

Våra BGA-monteringstjänster är mångsidiga och flexibla och rymmer olika BGA-komponenttyper och storlekar.
Kombinationen av rigorösa kvalitetskontrollåtgärder, röntgeninspektion och efterlevnad av industristandarder garanterar tillförlitligheten och prestandan hos de slutmonterade produkterna.
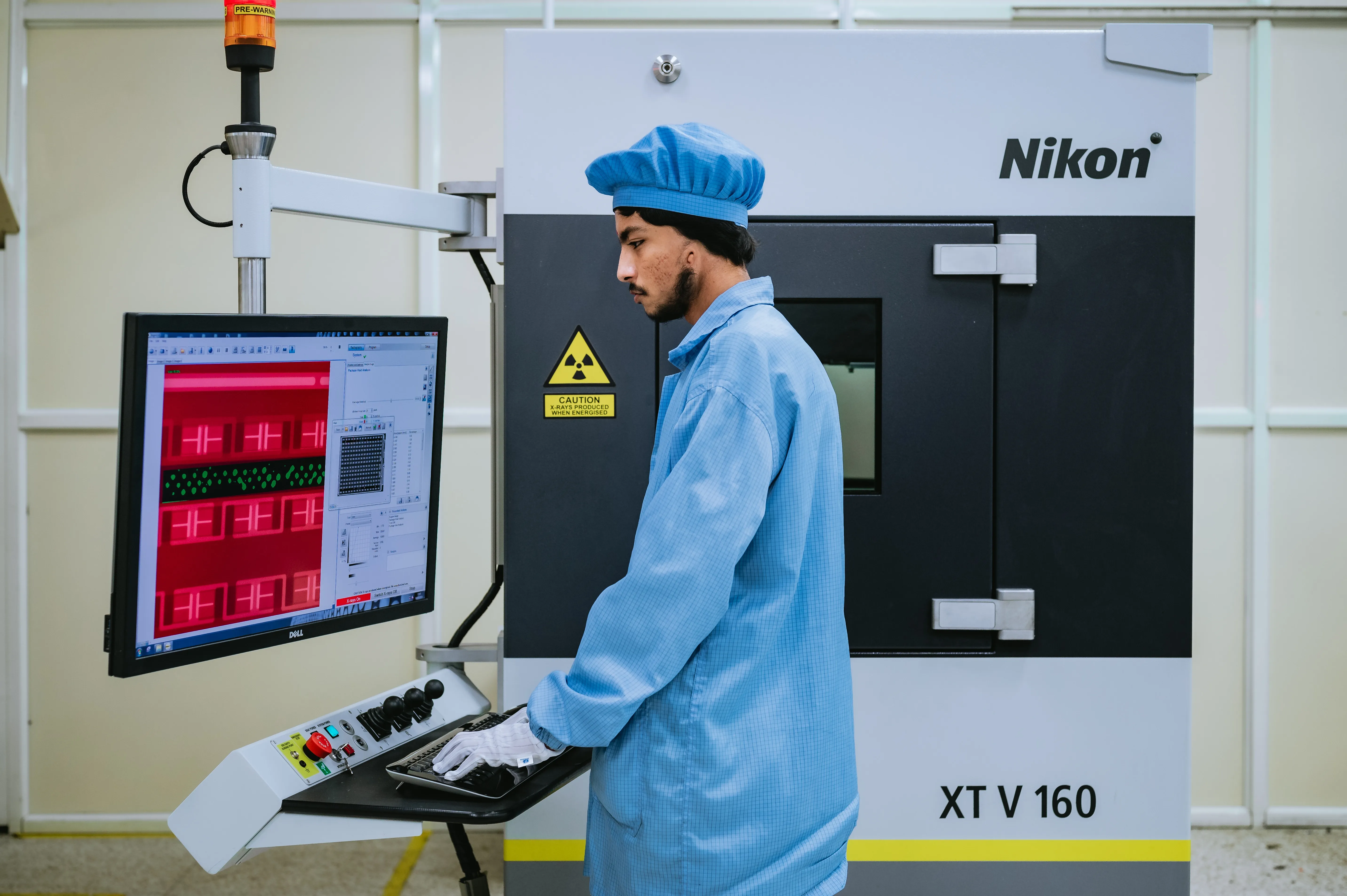
A BGA package is a type of surface mount packaging for integrated circuits that uses a grid of solder balls as its connectors. These solder balls provide the electrical connections to the PCB, enabling a compact and high-density connection layout.
BGA reballing is the process of removing old solder balls from a BGA component and replacing them with new ones. This repair technique is used to fix defective BGA solder joints or to reattach a BGA component to a PCB.
BGA stands for Ball Grid Array, a type of surface mount packaging used for integrated circuits. BGA packages use solder balls arranged in a grid on the bottom of the package for electrical and mechanical connection to the PCB.
In SMT (Surface Mount Technology), BGA refers to a type of packaging used for surface-mounted devices where solder balls on the underside of the package provide the electrical connections to the PCB, allowing for high-density connections.
BGA is important in PCB assembly for enabling high-density connections, reducing PCB size, and enhancing electrical performance. Its solder ball array allows for efficient manufacturing and reliable electrical connections, critical for modern, high-performance electronics.
There are several types of BGA, including PBGA (Plastic Ball Grid Array), CBGA (Ceramic Ball Grid Array), TBGA (Tape Ball Grid Array), and MBGA (Micro Ball Grid Array), each differing in materials and specific applications.
BGA is used in PCBs to achieve higher density connections, allowing more pins in less space compared to traditional packaging. This is crucial for modern electronic devices that require compact size with high functionality.
BGA is used for its ability to provide a large number of interconnections in a small space, improving performance and reducing size. The solder balls offer better joint reliability and heat conduction, suitable for high-performance and compact electronic devices.
The process of BGA production includes creating the BGA package with solder balls arranged in a grid pattern, placing the BGA on the PCB with precise alignment, and then soldering it using reflow soldering technique to create a solid mechanical and electrical bond.
A BGA chipset refers to a chipset packaged in a Ball Grid Array format. It is used in various electronic devices, such as computers and smartphones, for its efficient space utilization and reliable connections.
BGA assembly is the process of attaching Ball Grid Array (BGA) components to a printed circuit board (PCB) using surface mount technology (SMT) techniques. It involves applying solder paste, placing BGA components, and using reflow soldering to establish the connections.







